Lühendid
Enamus lühendeid elektroonikas ja seetõttu ka pindliite tehnoloogia terminoloogias on pärit ingliskeelsetest nimetustest.
Nii nagu ikka - on 2-3 tähelisi lühendeid raske meelde jätta, kui ei tea lühendi originaalkeelset täisnimetust (ingliskeelset nime). Seetõttu on allpool toodud lühenditele lisatud esmalt ingliskeelne nimetus, ja seejärel eestikeelne nimi, tõlge või selgitus - vastavalt vajadusele.
SMD - Surface Mount Device - Pindliite komponent
SMT - Surface Mount Technology - Pindliite tehnoloogia
SMA - Surface-mount assembly (module assembled with SMT) - pindliite koost
SMC - Surface-mount components (components for SMT) - pindliite komponendid
SMP - Surface-mount packages (SMD case forms) - pakendid pindliite komponentidele
SME - Surface-mount equipment (SMT assembling machines) - pindliite tehnoloogia seadmed
PCB - Printed Circuit Board - Trükkplaat
PWB - Printed Wire Board - Trükkplaat, sünonüüm PCB-le
THT - Through Hole Technology - Läbiviiktehnoloogia
CHIP - pindliitekomponent, risttahuka kujuline (nagu telliskivi) (paigaldatakse lapiti, nagu telliskivi.
MELF - Metal Electrode Leadless Face - pindliitekomponent, ümmargune, silindri kujuline, paigaldatakse "pikali", mitte püsti.
"Dual-in-line"
"flatpack" oli üks esimesi pindliite komponendi korpuse tüüpe (surface-mounted packages).
"Dual-in Line" on selline korpuseliik, kus väljaviigud on kahes reas.
MOP transistorid (ing. Metal Oxide Semiconductor Transistors) - metalloksiid transistorid
IGBT transistorid (ing. Insulated Gate Bipolar Transistors) - isoleeritud paisuga bipolaar transistor
SOIC: (Small-Outline Integrated Circuit), dual-in-line, 8 või rohkemate väljaviikudega 2-s reas, kullitiiva kujuliste väljaviikudega, kontaktid 1.27 mm sammuga.
SOJ: Small-Outline Package, J-Leaded - sama nagu SOIC kuid J-kujuliste väljaviikudega.
TSOP: Thin Small-Outline Package, - õhem, kui SOIC ja väiksema väljaviigu sammuga (0.5 mm)
SSOP: Shrink Small-Outline Package, pin sammuga 0.65 mm, mõnikord ka 0.635 mm või üksikutel juhtudel 0.8 mm
TSSOP: Thin Shrink Small-Outline package - õhuke väikeste mõõtmetega IC.
QSOP: Quarter-Size Small-Outline package, väljaviikude samm 0.635 mm
VSOP: Very Small Outline Package, - veelgi väiksem, kui QSOP; 0.4, 0.5 mm või 0.65 mm väljaviigu sammuks.
DFN: Dual Flat No-lead, smaller footprint than leaded equivalent Quad-in-line - jalgadeta komponent.- väljaviigud on vertikaalselt komponendi korpuse külgedel.
PLCC: Plastic Leaded Chip Carrier, square, J-lead, pin spacing 1.27 mm - plast korpuses IC
QFP: Quad Flat Package, various sizes, with pins on all four sides - ruudukujuline SMD komponent, kus väljaviigud on komponendi kõigil 4-l küljel.
LQFP: Low-profile Quad Flat Package, 1.4 mm high, varying sized and pins on all four sides - Madala profiiliga QFP
PQFP: Plastic Quad Flat-Pack, a square with pins on all four sides, 44 or more pins -plastkorpuses QFP. Väljaviike 44 või rohkem.
CQFP: Ceramic Quad Flat-Pack, similar to PQFP - keraamilise korpusega QFP
MQFP: Metric Quad Flat Pack, a QFP package with metric pin distribution - QFP meetermõõdustikus (nimelt on üldiselt mikreskeemide välismõõdud tollmõõdustiku alusel)
TQFP: Thin Quad Flat Pack, a thinner version of PQFP - õhem versioon PQFP-st
QFN: Quad Flat No-lead, smaller footprint than leaded equivalent - QFP ilma jalgadeta
LCC: Leadless Chip Carrier, - jalgadeta komponent - komponendi väljaviigud on komponendi korpuse külgedel vartikaalselt ainult. (contacts are recessed vertically to "wick-in" solder. Common in aviation electronics because of robustness to mechanical vibration).
MLP (MLF): Micro Leadframe Package (Micro Lead-Frame package) with a 0.5 mm contact pitch, no leads (same as QFN) - väga tihedate väljaviikudega, jalgadeta korpusega
PQFN: Power Quad Flat No-lead, with exposed die-pad[s] for heatsinking Grid arrays - Võimsus-QFP, jalgadeta
PGA: Pin grid array.- piikidega mitmes reas, kõigis 4-s küljes ruudukuline komponent, vastavasse IC pesasse paigaldamiseks. (vt. allolevat pilti)

Foto: http://en.wikipedia.org/wiki/File:XC68020_bottom_p1160085.jpg
CPGA - keraamilise korpusega PGA
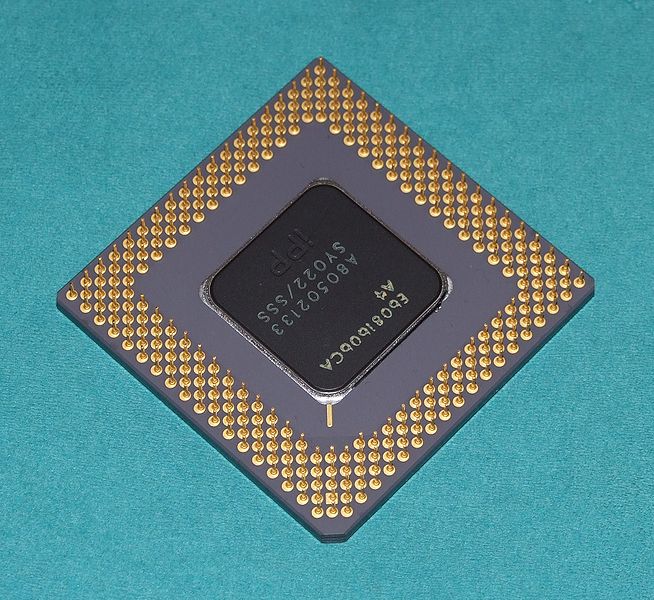
http://en.wikipedia.org/wiki/File:Pentium_P54_Socket7_PGA.jpg
133 MHz Pentium chip in a ceramic package
BGA: Ball Grid Array, with a square or rectangular array of solder balls on one surface, ball spacing typically 1.27 mm - BGA komponent on ruudukujuline, ning kõik kontaktid on selle komponendi all maatriksina ühes tasapinnas nagu väikesed kuulikesed (pallid - sellest ka nimetus). Käsitsi sellist komponenti trükkplaadile joota pole võimalik - vaid ainult masinaga, samuti pole võimalik selle komponendi jootekvaliteeti kontrollida muul viisil kui ainult röntgeniga.
Siin ongi rõngtenpilt BGA komponendi jootekohtadest trükkplaadile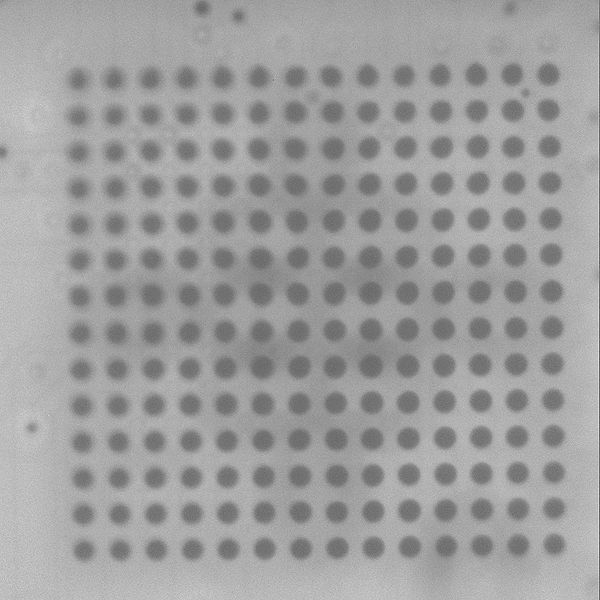
http://en.wikipedia.org/wiki/File:BGA_joint_xray.jpg
LGA: An array of bare lands only. Similar to in appearance to QFN, but mating is by spring pins within a socket rather than solder. - sarnane QFN-le
FBGA: Fine pitch Ball Grid Array, with a square or rectangular array of solder balls on one surface
LFBGA: Low profile Fine pitch Ball Grid Array, with a square or rectangular array of solder balls on one surface, ball spacing typically 0.8 mm - hästi tiheda kontaktivõrguga BGA
TFBGA: Thin Fine pitch Ball Grid Array, with a square or rectangular array of solder balls on one surface, ball spacing typically 0.5 mm
CGA: Column Grid Array, circuit package in which the input and output points are high temperature solder cylinders or columns arranged in a grid pattern.
CCGA: Ceramic Column Grid Array, circuit package in which the input and output points are high temperature solder cylinders or columns arranged in a grid pattern. The body of the component is ceramic.
uBGA: micro-BGA, with ball spacing less than 1 mm - mikro BGA, kontakt-kuulikest tihedusega alla 1 mm
LLP: Lead Less Package, a package with metric pin distribution (0.5 mm pitch).
Non-packaged devices (although surface-mount, these devices require specific process for assembly): - jalgadeta korpusega komponent pindliite tehnoloogias
COB: Chip-On-Board; a bare silicon chip, that is usually an integrated circuit, is supplied without a package (usually a lead frame overmolded with epoxy) and is attached, often with epoxy, directly to a circuit board. The chip is then wire bonded and protected from mechanical damage and contamination by an epoxy "glob-top".
COF: Chip-On-Flex; a variation of COB, where a chip is mounted directly to a flex circuit.
COG: Chip-On-Glass; a variation of COB, where a chip, typically a Liquid crystal display (LCD) controller, is mounted directly on glass:.- tüüpiline vedelkristall - mikroskeem klaasil
Tihti varieeruvad markeeringud pakenditel sõltuvalt tootjast. Disainerid peavad toodete loomisel arvestama komponentide reaalsete parameetritega, mille alusel kujundatakse välja seadme arhitektuur.






